高精度、高彈性、智慧辨識,全面提升封裝製程品質
在半導體晶片封裝過程中,「底膠(Underfill)」品質將直接影響產品的機械強度與熱循環可靠性。本方案提供 AOI + AI 整合式自動光學檢測系統,可快速精準地辨識以下關鍵瑕疵類型:
支援瑕疵檢測項目
♦ 缺膠(Missing underfill fillet):未100%覆蓋Die邊緣
♦ 溢膠(UF Bleeding / Splat / Droplet):自晶粒邊緣算起至基板端點處>3mm ,拒收(BGA)
♦ 爬膠(Creeping):底膠爬升至焊墊或元件的區域,干擾組裝
♦ 晶背污染(Backside Contamination):異物粒子殘留 > 50mil
♦ 2D條碼辨識失敗:封裝成品識別碼無法正確讀取
晶片Underfill 瑕疵檢測解決方案|AOI+AI整合式智慧光學系統
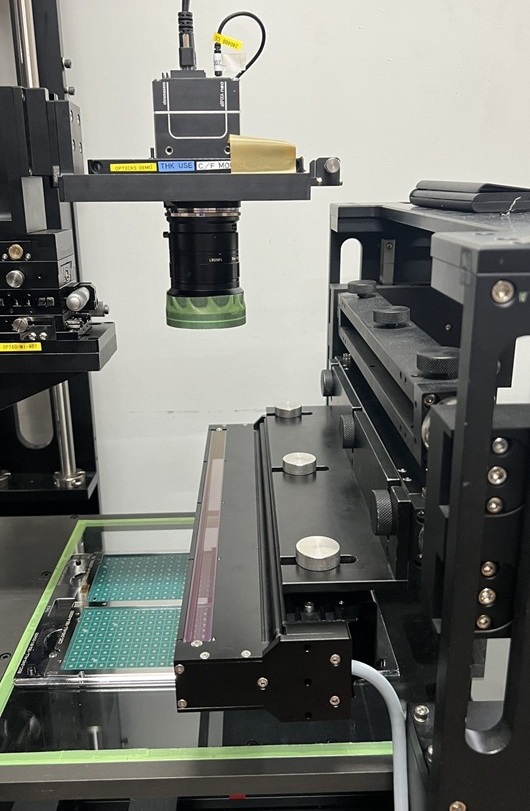
詳細資訊

智慧AI瑕疵識別技術
透過深度學習模型訓練與上百張影像資料,AI模組可自動判別瑕疵特徵,並支援以下智慧控管功能:
♦ 客製化容許範圍設定(如:爬膠寬度是否 >100µm)
♦ 單邊異常距離 >100µm / 面積 >150µm 瑕疵可自動標示
♦ 可依製程與產品特性彈性調整檢測門檻
升級既有設備,提高良率效益
本解決方案可彈性整合至現有AOI平台,透過加裝 光學模組 + AI演算法,實現以下效益:
♦ 提升晶片表面缺陷檢出能力
♦ 自動記錄與分類缺陷,支援SPC品管分析
♦ 降低人工誤判率,提高製程效率
📞 歡迎聯絡我們,了解如何快速導入Underfill AOI/AI智慧檢測,為您的製程品質保駕護航!
