在切割後探測邊緣碎裂或毛邊
區分切割流程完成後出現的缺陷與可接受的切口痕跡
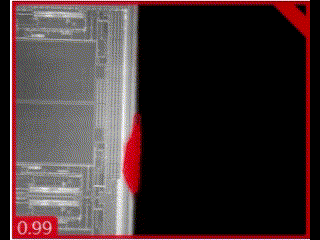
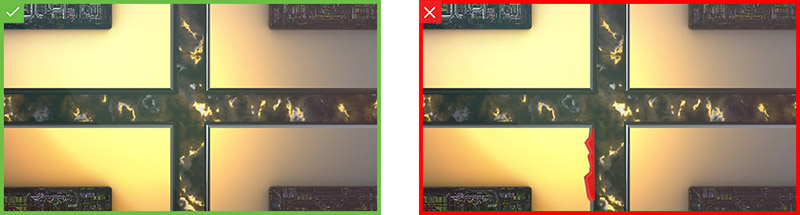
歡迎您透過LINE直接詢問或報價:
請於LINE ID搜尋 @yuyou
晶圓會在經過多項不同的層疊與蝕刻流程之後,切割成個別的晶粒。完成此程序之後的晶粒切口沿線可能會留有碎裂或毛邊痕跡。碎裂與毛邊都會影響 IC 裝置品質,因此務必要在切割完成後檢測出來。超出誤差範圍的碎裂處若高於平均數,也表示可能需要調整或更換切割鋸片。
檢測晶粒的常見方式為使用基於規則的機器視覺,但這種方法通常不夠可靠,因為碎裂與毛邊痕跡的樣態多變,也很難與正常的切割痕跡或 IC 圖案區分。開發機器視覺演算法,以涵蓋所有變化並區分不可接受的痕跡與在誤差範圍內的痕跡,並非易事。
Cognex Deep Learning 工具提供更簡單的方式,來學習和分類碎裂與毛邊痕跡,以及與切割流程後的正常切口痕跡區分。輕鬆訓練軟體,識別所有碎裂與毛邊,分類為可接受或不可接受,以及忽略在誤差範圍內的正常痕跡。
製造廠商可以使用這項資訊精進切割流程,例如替換已變得不夠鋒利或太寬的鑽石鋸片。適當探測 OK 與不良 (NG) 之間差異的另一項優點,就是挽救可能因為誤讀而遭到丟棄的良好晶片,進而提高成品率。
